BGA底部填充胶点胶工艺标准和选择与评估由汉思化学提供
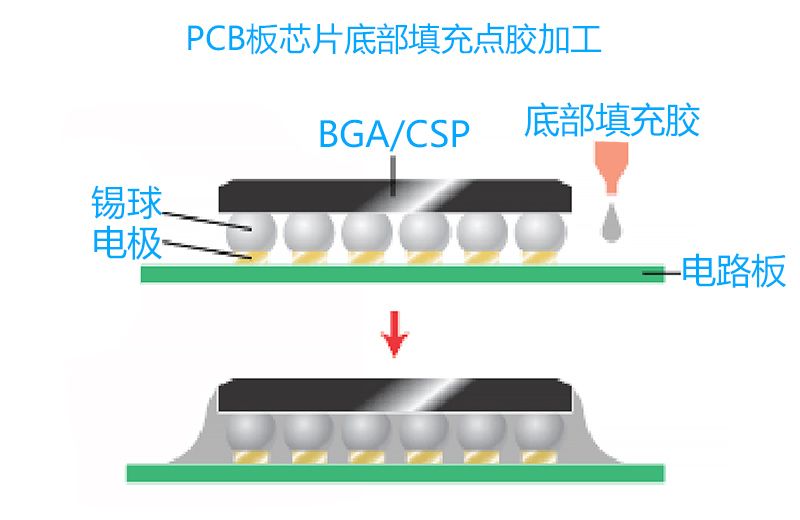
由于 BGA 芯片存在因应力集中而出现的可靠性质量隐患问题,为了使 BGA 封装具备更高的机械可靠性,需对 BGA 进行底部填充,而正确选择底部填充胶对产品可靠性有很大影响。
随着电子行业高精密、智能化的发展,BGA封装芯片在电子组装中应用越来越广泛,随之而来的则是BGA芯片容易因应力集中导致的可靠性质量隐患问题。为了使BGA封装工艺获得更高的机械可靠性,需对BGA进行底部填充。
底部填充胶简单来说就是底部填充之义,对BGA /PCB封装模式的芯片进行底部填充,利用加热的固化形式,将BGA 底部空隙大面积 (一般覆盖80%以上)填满,从而达到加固的目的,增强BGA 封装模式的芯片和PCB之间的机械可靠性。
底部填充的主要作用
1)填补PCB基板与BGA封装之间的空隙,提供机械连接作用,并将焊点密封保护起来
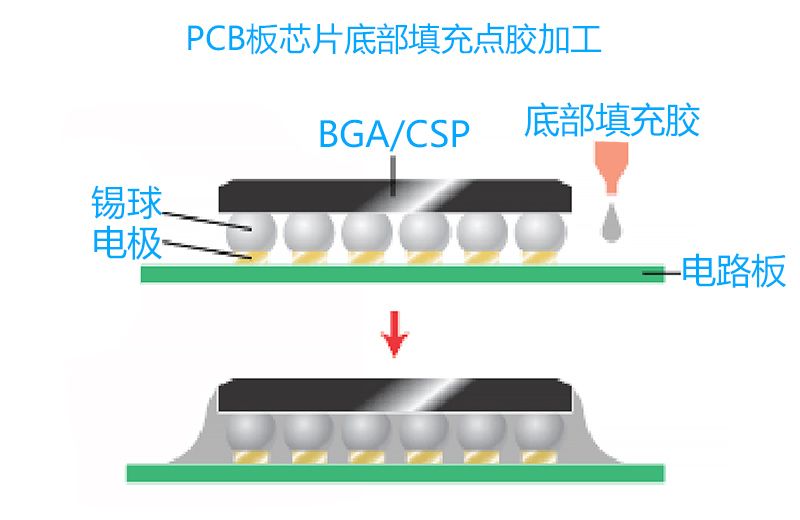
由于 BGA 芯片存在因应力集中而出现的可靠性质量隐患问题,为了使 BGA 封装具备更高的机械可靠性,需对 BGA 进行底部填充,而正确选择底部填充胶对产品可靠性有很大影响。
随着电子行业高精密、智能化的发展,BGA封装芯片在电子组装中应用越来越广泛,随之而来的则是BGA芯片容易因应力集中导致的可靠性质量隐患问题。为了使BGA封装工艺获得更高的机械可靠性,需对BGA进行底部填充。
底部填充胶简单来说就是底部填充之义,对BGA /PCB封装模式的芯片进行底部填充,利用加热的固化形式,将BGA 底部空隙大面积 (一般覆盖80%以上)填满,从而达到加固的目的,增强BGA 封装模式的芯片和PCB之间的机械可靠性。
底部填充的主要作用
1)填补PCB基板与BGA封装之间的空隙,提供机械连接作用,并将焊点密封保护起来
